重庆群崴电子材料有限公司
重庆群崴电子材料有限公司是一家专业从事电子封装材料研发和生产的国家高新技术创新型企业。公司拥有多项相关核心技术专利,是国内雾化成型BGA锡球技术专利持有人。其中0.25mm 以下的BGA 锡球被列为国家863(“863”计划)重点项目之一。
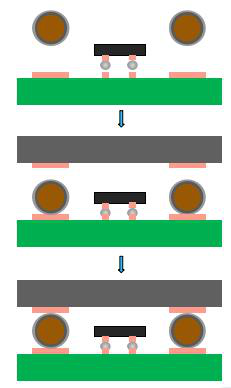
3D封装技术的解决方案之铜核球
近年来,移动电子产品的市场需求迅速扩大,以智能手机为例,中国智能手机销售量由2011年的0.96亿部上升到2015年的4.2亿部。伴随着移动电子产品轻量化、纤薄化和多功能化的发展,传统电子封装技术无法满足小型化、窄间距化和多针化的要求。为了满足这些市场要求,以堆叠封装(POP)为代表的3D封装技术应运而生。3D封装起源于快闪存储器和SDRAM的叠层封装,它是一种在不改变封装体尺寸的前提下,在同一个封装体内于垂直方向叠放两个以上芯片的封装技术,其主要特点包括:多功能、高效能、大容量、高密度和低成本。

陶瓷柱阵列封装新选择---螺旋锡柱
军用微电子组件的可用性一直在稳步下降。这迫使高可靠性要求的用户利用商业现货(COTS)组件以满足他们的需求。而商用级元件不能总是满足恶劣环境下应用的可靠性要求。为了满足这种需求, COTS元件的强化技术便得到迅速发展。

无铅电子时代的“隐形杀手”---锡须
在无铅电子时代,镀锡工艺在商业化和高可靠性的电子器件上是很常见的。锡镀层不仅具有优良的可焊性和导电性,而且还具有良好的抗氧化性及耐腐蚀性,同时还具有一定的美观性。不幸的是,电镀纯锡会生长单晶结构的晶须,这成为电子器件不期失效罪魁祸首。
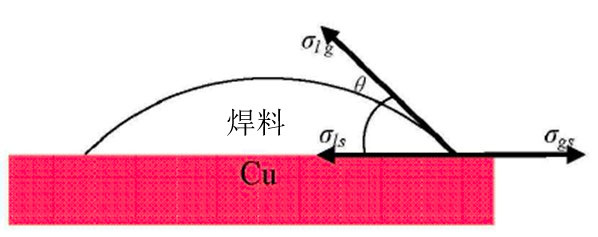
SAC305焊料的润湿性
引言 电子器件封装后,焊料合金和衬底材料形成的冶金连接为其提供了必不可少的导电、导热和机械连接,因此焊料合金的焊接性能直接决定着焊点可靠性,甚至是整个电子设备的服役寿命。其中,焊料合金和衬底材料之间良好的润湿是确保焊点可靠连接的前提条件。在焊料无铅化和电子芯片微型化的进程中,人们正在寻找可以替代SnPb共晶的焊料,目前常用的是Sn3Ag0.5Cu(SAC305)焊料合金。但SAC305焊料相比SnPb焊料,仍然有以下两点不足: 1、由于无铅焊料的润湿性比SnPb共晶焊料差,因此在钎焊过程中可能会出现焊料的润湿性能不能满足要求、焊料的自校准能力差及焊点可靠性不达标等问题。 SAC焊料的熔点(大约490K)高于传统的SnPb焊料合金(456K),这将导致回流焊或波峰焊过程中焊接温度的升高,进而引起焊料氧化及形成过厚的金属间化合物,影响了焊点的可靠连接。