新闻中心
NEWS

联 系 人:
祝新秀
咨询热线:
15223848168
公司邮箱:
sd02@qunwin.com
客服QQ :
876843941
公司地址:
重庆市涪陵区李渡工业园A栋
3D封装技术的解决方案之铜核球
背景
近年来,移动电子产品的市场需求迅速扩大,以智能手机为例,中国智能手机销售量由2011年的0.96亿部上升到2015年的4.2亿部。伴随着移动电子产品轻量化、纤薄化和多功能化的发展,传统电子封装技术无法满足小型化、窄间距化和多针化的要求。为了满足这些市场要求,以堆叠封装(POP)为代表的3D封装技术应运而生。3D封装起源于快闪存储器和SDRAM的叠层封装,它是一种在不改变封装体尺寸的前提下,在同一个封装体内于垂直方向叠放两个以上芯片的封装技术,其主要特点包括:多功能、高效能、大容量、高密度和低成本。
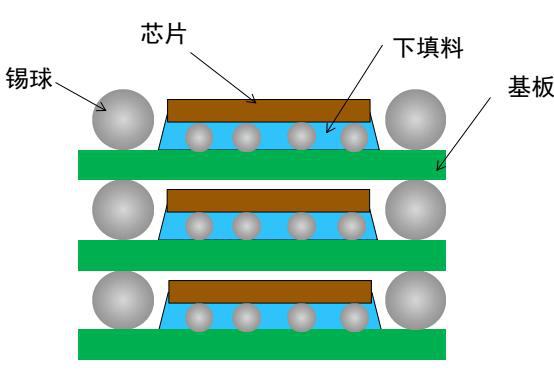
图1 典型3D封装结构示意图
铜核球

图2 铜核球结构示意图
铜核球(CCSB)是一种复合式多层次的焊锡球,一般包含铜球、镀镍层、镀锡层三部分,如图2所示。铜球核心是铜核球区别于传统BGA锡球关键结构,直径一般在0.03-0.5mm;镀镍层厚度一般在2-3um,其主要作用是降低铜球和基板或钎料镀层之间的润湿行为,有效的防止铜和基板或钎料镀层中其它金属间的扩散,镀镍层为非必需层,可以根据基板材质和钎料镀层进行考虑;钎料镀层是铜核球的有效焊接部分,厚度通常在3-30um,成分可以根据焊接性能和条件不同采用纯锡,SAC,SC等。
铜核球的制备
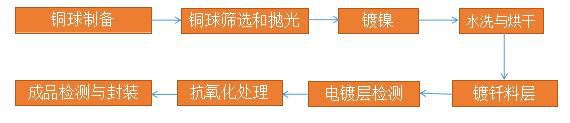
图3 铜核球的生产工艺流程图
图3是铜核球的生产工艺流程图。从图3可以看出制备铜核球的关键在于铜球制备和电镀两个环节。电镀镍和钎料在目前是比较成熟的的工艺,根据客户产品的需求,选择合理的电镀工艺既可保证产品质量。如何生产出真圆度高铜球是目前铜核球生产中首要问题和技术难点。
铜核球的封装工艺
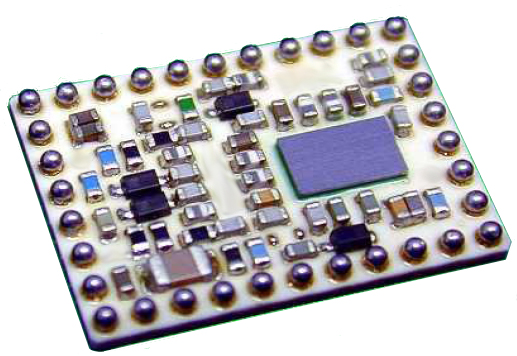
图5 铜核球在PCB板上的封装图
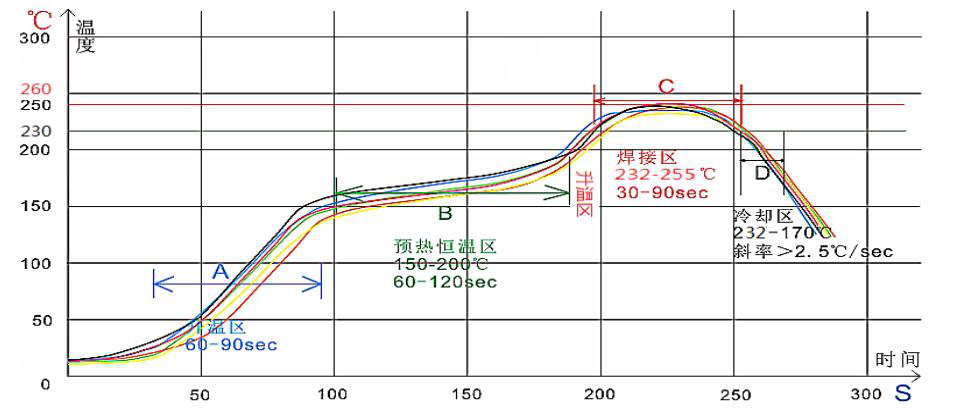
图6 铜核球封装过程示意图及回流焊建议温度曲线
从图6中可知,铜核球的封装过程与传统BGA锡球基本一致,现有的植球机和助焊剂印刷机等设备都能够得到使用。其回流焊温度曲线和BGA锡球的基本一致,建议回流焊温度曲线如图6所示。
铜核球与传统BGA锡球焊点分析
传统BGA锡球的3D封装
图7是传统BGA锡球实现3D封装的示意图。3D封装需要多次热制程,而传统BGA锡球在经过250℃多次反复受热,焊接凸点会熔融,这样在多层次电子零件重量的压迫下会使焊接凸点发生不可接受变形,从而导致封装空间变窄,焊点之间或焊点与零件之间粘连短路等问题。
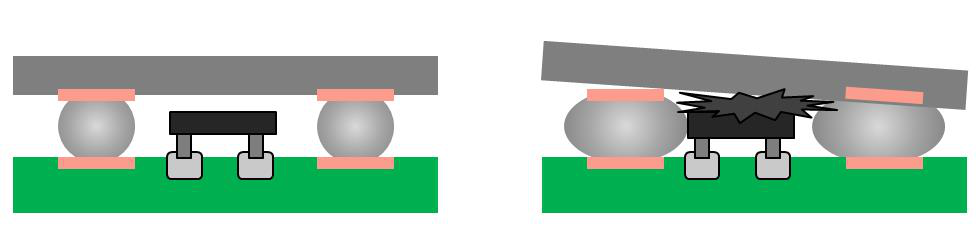
图7 传统锡球3D封装示意图
铜核球的3D封装
图8是铜核球实现3D封装的示意图。铜核球核心为一定尺寸的铜金属,铜的熔点(1083℃)远高于钎焊温度(250℃),这样即使经过多次回焊过程,铜球部分也不会发生不可接受变形,维持封装空间不变,而这个稳定的空间即可容纳和封装其他电子零件。铜核球能够确保回焊后封装空间稳定的这一特性,有利于实现高密度的3D封装。

图8铜核球3D封装示意图
此外,铜核球还具有优良的耐电迁移和热迁移特性。随着电子器件的多功能化、高性能,微型化的发展,极大的促进了高密度封装的发展,芯片上I/O引脚数量增多,焊点面积减少,从而导致电流密度变高;电流密度的增大会加剧焊点的电迁移失效。相较于传统BGA锡球焊点,铜核球焊点具有更好的抗电迁移和热迁移特性,这是因为铜核芯的导电性能是锡球的5-10倍,导热性能也明显优于传统锡球。
另外有资料显示,有效焊接成分相同的情况下,电镀铜核球焊点抗落下冲击性能明显优于传统锡球,而热疲劳测试结果与传统锡球一致。这说明铜核球焊点具有优良的耐热疲劳特性和耐落下冲击性。
展望
总之,鉴于其能够稳定保持封装空间,具有优良的耐电迁移和热迁移特性及焊点的热疲劳特性、耐落下冲击性,铜核球作为3D封装技术的解决方案,具有较好的应用前景。